
许多微电子器件(如加速度计、陀螺仪、深紫外LED等)芯片对空气、湿气、灰尘等非常敏感。如LED芯片理论上可工作10万小时以上,但水汽侵蚀会大大缩短其寿命。为了提高这些微电子器件性能,必须将其芯片封装在真空或保护气体中,实现气密封装。因此,必须首先制备含腔体(围坝)结构的三维陶瓷基板,满足封装应用需求。三维陶瓷基板性能对比↓↓

目前,常见的三维陶瓷基板主要有:高/低温共烧陶瓷基板(HTCC/LTCC)、多层烧结三维陶瓷基板(MSC)、直接粘接三维陶瓷基板(DAC)、多层镀铜三维陶瓷基板(MPC)以及直接成型三维陶瓷基板(DMC)等。
01高/低温共烧陶瓷基板(HTCC/LTCC)HTCC基板制备过程中先将陶瓷粉(Al2O3或AlN)加入有机黏结剂,混合均匀后成为膏状陶瓷浆料,接着利用刮刀将陶瓷浆料刮成片状,再通过干燥工艺使片状浆料形成生胚;然后根据线路层设计钻导通孔,采用丝网印刷金属浆料进行布线和填孔,最后将各生胚层叠加,置于高温炉(1600℃)中烧结而成。由于HTCC基板制备工艺温度高,因此导电金属选择受限,只能采用熔点高但导电性较差的金属(如W、Mo及Mn等),制作成本较高。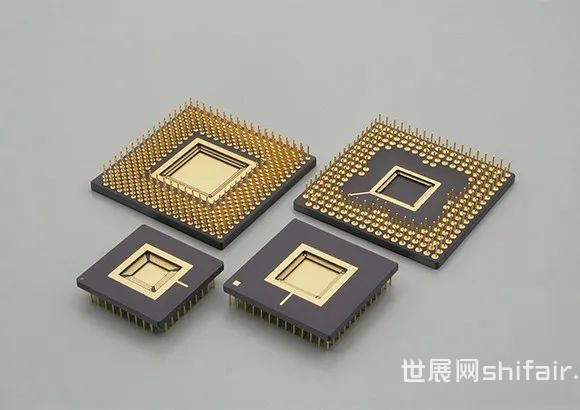
此外,受到丝网印刷工艺限制,HTCC基板线路精度较差,难以满足高精度封装需求。但HTCC基板具有较高机械强度和热导率[20W/(m·K)~200W/(m·K)],物化性能稳定,适合大功率及高温环境下器件封装。为了降低HTCC制备工艺温度,同时提高线路层导电性,业界开发了LTCC基板。与HTCC制备工艺类似,只是LTCC制备在陶瓷浆料中加入了一定量玻璃粉来降低烧结温度,同时使用导电性良好的Cu、Ag和Au等制备金属浆料。LTCC基板制备温度低,但生产效率高,可适应高温、高湿及大电流应用要求,在军工及航天电子器件中得到广泛应用。
LTCC制备工艺流程
虽然LTCC基板具有上述优势,但由于在陶瓷浆料中添加了玻璃粉,导致基板热导率偏低[一般仅为3W/(m·K)~7W/(m·K)]。此外,与HTCC一样,由于LTCC基板采用丝网印刷技术制作金属线路,有可能因张网问题造成对位误差,导致金属线路层精度低;而且多层陶瓷生胚叠压烧结时还存在收缩比例差异问题,影响成品率,一定程度上制约了LTCC基板技术发展。02多层烧结三维陶瓷基板(MSC)与HTCC/LTCC基板一次成型制备三维陶瓷基板不同,台湾阳升公司采用多次烧结法制备了MSC基板。首先制备厚膜印刷陶瓷基板(TPC),随后通过多次丝网印刷将陶瓷浆料印刷于平面TPC基板上,形成腔体结构,再经高温烧结得到MSC基板。由于陶瓷浆料烧结温度一般在800℃左右,因此要求下部的TPC基板线路层必须能耐受如此高温,防止在烧结过程中出现脱层或氧化等缺陷。TPC基板线路层由金属浆料高温烧结(一般温度为850℃~900℃)制备,具有较好的耐高温性能,适合后续采用烧结法制备陶瓷腔体。

MSC陶瓷基板制备工艺流程
 MSC基板技术生产设备和工艺简单,平面基板与腔体结构独立烧结成型,且由于腔体结构与平面基板均为无机陶瓷材料,热膨胀系数匹配,制备过程中不会出现脱层、翘曲等现象。其缺点在于,下部TPC基板线路层与上部腔体结构均采用丝网印刷布线,图形精度较低;同时,因受丝网印刷工艺限制,所制备的MSC基板腔体厚度有限。因此MSC三维基板仅适用于体积较小、精度要求不高的电子器件封装。03直接粘接三维陶瓷基板(DAC)上述HTCC、LTCC及MSC基板线路层都采用丝网印刷制备,精度较低,难以满足高精度、高集成度封装要求,因此业界提出在高精度DPC陶瓷基板上成型腔体制备三维陶瓷基板。由于DPC基板金属线路层在高温(超过300℃)下会出现氧化、起泡甚至脱层等现象,因此基于DPC技术的三维陶瓷基板制备必须在低温下进行。
MSC基板技术生产设备和工艺简单,平面基板与腔体结构独立烧结成型,且由于腔体结构与平面基板均为无机陶瓷材料,热膨胀系数匹配,制备过程中不会出现脱层、翘曲等现象。其缺点在于,下部TPC基板线路层与上部腔体结构均采用丝网印刷布线,图形精度较低;同时,因受丝网印刷工艺限制,所制备的MSC基板腔体厚度有限。因此MSC三维基板仅适用于体积较小、精度要求不高的电子器件封装。03直接粘接三维陶瓷基板(DAC)上述HTCC、LTCC及MSC基板线路层都采用丝网印刷制备,精度较低,难以满足高精度、高集成度封装要求,因此业界提出在高精度DPC陶瓷基板上成型腔体制备三维陶瓷基板。由于DPC基板金属线路层在高温(超过300℃)下会出现氧化、起泡甚至脱层等现象,因此基于DPC技术的三维陶瓷基板制备必须在低温下进行。

DAC三维陶瓷基板制备工艺流程
 台湾瑷司柏公司(ICP)提出采用胶粘法制备三维陶瓷基板。首先加工金属环和DPC陶瓷基板,然后采用有机粘胶将金属环与DPC基板对准后粘接、加热固化。由于胶液流动性好,涂胶工艺简单,成本低,易于实现批量生产,且所有制备工艺均在低温下进行,不会对DPC基板线路层造成损伤。但由于有机粘胶耐热性差,固化体与金属、陶瓷间热膨胀系数差较大,且为非气密性材料,目前DAC陶瓷基板主要应用于线路精度要求较高,但对耐热性、气密性、可靠性等要求较低的电子器件封装。为了解决上述不足,业界进一步提出采用无机胶替代有机胶的粘接技术方案,大大提高了DAC三维陶瓷基板的耐热性和可靠性。其技术关键是选用无机胶,要求其能在低温(低于200℃)下固化;固化体耐热性好(能长期耐受300℃高温),与金属、陶瓷材料粘接性好(剪切强度大于10MPa),同时与金属环(围坝)和陶瓷基片材料热膨胀系数匹配(降低界面热应力)。04多层电镀三维陶瓷基板(MPC)MPC基板采用图形电镀工艺制备线路层,避免了HTCC/LTCC与TPC基板线路粗糙问题,满足高精度封装要求。陶瓷基板与金属围坝一体化成型为密封腔体,结构紧凑,无中间粘结层,气密性高。
台湾瑷司柏公司(ICP)提出采用胶粘法制备三维陶瓷基板。首先加工金属环和DPC陶瓷基板,然后采用有机粘胶将金属环与DPC基板对准后粘接、加热固化。由于胶液流动性好,涂胶工艺简单,成本低,易于实现批量生产,且所有制备工艺均在低温下进行,不会对DPC基板线路层造成损伤。但由于有机粘胶耐热性差,固化体与金属、陶瓷间热膨胀系数差较大,且为非气密性材料,目前DAC陶瓷基板主要应用于线路精度要求较高,但对耐热性、气密性、可靠性等要求较低的电子器件封装。为了解决上述不足,业界进一步提出采用无机胶替代有机胶的粘接技术方案,大大提高了DAC三维陶瓷基板的耐热性和可靠性。其技术关键是选用无机胶,要求其能在低温(低于200℃)下固化;固化体耐热性好(能长期耐受300℃高温),与金属、陶瓷材料粘接性好(剪切强度大于10MPa),同时与金属环(围坝)和陶瓷基片材料热膨胀系数匹配(降低界面热应力)。04多层电镀三维陶瓷基板(MPC)MPC基板采用图形电镀工艺制备线路层,避免了HTCC/LTCC与TPC基板线路粗糙问题,满足高精度封装要求。陶瓷基板与金属围坝一体化成型为密封腔体,结构紧凑,无中间粘结层,气密性高。
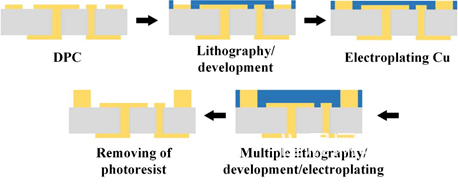
MPC陶瓷基板制备工艺流程
 MPC基板整体为全无机材料,具有良好的耐热性,抗腐蚀、抗辐射等。金属围坝结构形状可以任意设计,围坝顶部可制备出定位台阶,便于放置玻璃透镜或盖板,目前已成功应用于深紫外LED封装和VCSEL激光器封装,已部分取代LTCC基板。其缺点在于:由于干膜厚度限制,制备过程需要反复进行光刻、显影、图形电镀与表面研磨,耗时长(厚度为600μm围坝需要电镀10h以上),生产成本高;此外,由于电镀围坝铜层较厚,内部应力大,MPC基板容易翘曲变形,影响后续的芯片封装质量与效率。05直接成型三维陶瓷基板(DMC)DMC基板的制备,首先制备平面DPC陶瓷基板,同时制备带孔橡胶模具;将橡胶模具与DPC陶瓷基板对准合模后,向模具腔内填充牺牲模材料;待牺牲模材料固化后,取下橡胶模具,牺牲模粘接于DPC陶瓷基板上,并精确复制橡胶模具孔结构特征,作为铝硅酸盐浆料成型模具;随后将铝硅酸盐浆料涂覆于DPC陶瓷基板上并刮平,加热固化,最后将牺牲模材料腐蚀,得到含铝硅酸盐免烧陶瓷围坝的三维陶瓷基板。
MPC基板整体为全无机材料,具有良好的耐热性,抗腐蚀、抗辐射等。金属围坝结构形状可以任意设计,围坝顶部可制备出定位台阶,便于放置玻璃透镜或盖板,目前已成功应用于深紫外LED封装和VCSEL激光器封装,已部分取代LTCC基板。其缺点在于:由于干膜厚度限制,制备过程需要反复进行光刻、显影、图形电镀与表面研磨,耗时长(厚度为600μm围坝需要电镀10h以上),生产成本高;此外,由于电镀围坝铜层较厚,内部应力大,MPC基板容易翘曲变形,影响后续的芯片封装质量与效率。05直接成型三维陶瓷基板(DMC)DMC基板的制备,首先制备平面DPC陶瓷基板,同时制备带孔橡胶模具;将橡胶模具与DPC陶瓷基板对准合模后,向模具腔内填充牺牲模材料;待牺牲模材料固化后,取下橡胶模具,牺牲模粘接于DPC陶瓷基板上,并精确复制橡胶模具孔结构特征,作为铝硅酸盐浆料成型模具;随后将铝硅酸盐浆料涂覆于DPC陶瓷基板上并刮平,加热固化,最后将牺牲模材料腐蚀,得到含铝硅酸盐免烧陶瓷围坝的三维陶瓷基板。
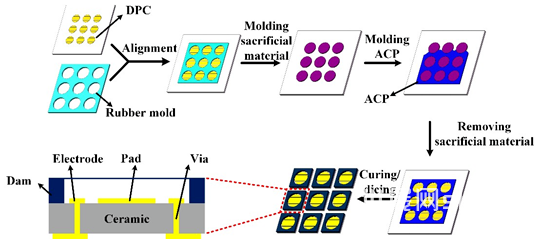
DMC陶瓷基板制备工艺流程
 铝硅酸盐浆料固化温度低,对DPC陶瓷基板线路层影响极小,并与DPC基板制备工艺兼容。橡胶具有易加工、易脱模以及价格低廉等特点,能精确复制围坝结构(腔体)形状与尺寸,保证围坝加工精度。有实验结果表明,腔体深度、直径加工误差均小于30μm,说明该工艺制备的三维陶瓷基板精度高,重复性好,适合量产。铝硅酸盐浆料加热后脱水缩合,主要产物为无机聚合物,其耐热性好,热膨胀系数与陶瓷基片匹配,具有良好的热稳定性;固化体与陶瓷、金属粘接强度高,制备的三维陶瓷基板可靠性高。围坝厚度(腔体高度)取决于模具厚度,理论上不受限制,可满足不同结构和尺寸的电子器件封装要求。声 明:文章内容来源电介质Dielectrics,仅作分享,不代表本号立场,如有侵权,请联系小编删除,谢谢!
铝硅酸盐浆料固化温度低,对DPC陶瓷基板线路层影响极小,并与DPC基板制备工艺兼容。橡胶具有易加工、易脱模以及价格低廉等特点,能精确复制围坝结构(腔体)形状与尺寸,保证围坝加工精度。有实验结果表明,腔体深度、直径加工误差均小于30μm,说明该工艺制备的三维陶瓷基板精度高,重复性好,适合量产。铝硅酸盐浆料加热后脱水缩合,主要产物为无机聚合物,其耐热性好,热膨胀系数与陶瓷基片匹配,具有良好的热稳定性;固化体与陶瓷、金属粘接强度高,制备的三维陶瓷基板可靠性高。围坝厚度(腔体高度)取决于模具厚度,理论上不受限制,可满足不同结构和尺寸的电子器件封装要求。声 明:文章内容来源电介质Dielectrics,仅作分享,不代表本号立场,如有侵权,请联系小编删除,谢谢!


























